摘要
在半导体晶圆加工过程中, 组合设备中的加工腔环境达到污染阈值时需要进行清洁以确保加工晶圆质量. 针对存在晶圆驻留时间约束及并行加工腔配置的双臂机械手组合设备, 在一个加工腔达到污染阈值需进行清洁操作的情况, 本文研究了机械手的调度. 由于加工腔需清洁, 组合设备的生产周期会变长. 为此, 本文提出了加载虚拟晶圆的方法来延长生产周期并使机械手的活动顺序与清洁前保持一致, 使得清洁操作能获得足够的时间来完成. 在确保正常运行的加工腔中晶圆的驻留时间约束得到满足的条件下, 根据各步骤的工作负载平衡的不同情况, 提出算法采用解析式推导计算新的生产周期和机械手等待事件的持续时间, 使组合设备进入暂态进行清洁操作以及使组合设备恢复到稳态过程运行. 本文提出的多项式复杂度的算法, 提高了双臂机械手组合设备在清洁情况下的生产效率.
Abstract
In a semiconductor manufacturing factory, a cluster tool consists of several process chambers and a robot for transporting wafers. During wafer fabrication, a process chamber must be cleaned when its processing environment reaches a contamination threshold to ensure wafer quality. This work focuses on a dual-arm cluster tool with parallel process chambers when wafer residency time constraints are imposed on processed wafers. The chamber must be cleaned when the contamination accumulates to a given threshold. This work studies the scheduling of the robot for such a scenario. Due to a cleaning operation, the cycle time of a cluster tool must be extended. To this end, this work proposes a method based on a virtual wafer, which can 1) keep the robot operation sequence the same as before the cleaning operation and 2) obtain enough time to perform a cleaning operation. When the wafer residency time constraints at the regular steps are satisfied, we analyze the workload balance of process steps for a cluster tool and propose algorithms based on closed-form calculations. The algorithms can 1) determine the variable cycle time of a cluster tool and the robot waiting time before unloading a wafer, 2) switch a cluster tool from a steady state to a cleaning transient state, and 3) back to an original steady state. The computational complexity of the proposed algorithms is polynomial and can improve the productivity of a cluster tool in the case of a cleaning operation.
Keywords
1 引言
半导体制造业是公认的资本密集型产业,也是最先进、最复杂、自动化程度最高的产业之一 [1] . 半导体芯片以硅片晶圆为原料载体,制造过程涉及几百甚至上千个加工晶圆的工艺步骤. 组合设备(cluster tool)在常用的光刻、蚀刻和沉积等晶圆加工过程中发挥着重要作用,可以有效满足大尺寸晶圆的工艺复杂和质量严苛等生产需求. 如图1所示,一台组合设备由多个加工腔(process chamber,PC)、一个对准模块、一个传输晶圆的机械手和两个晶圆真空锁(loadlock,LL)组成 [2-3] . 一个装有25片晶圆的卡盒(cassette)通常采用相同的工艺流程. 其中的晶圆按照在卡盒里的顺序逐一进入加工腔,并返回到真空锁 [4] . 组合设备可以配置单臂机械手或双臂机械手,分别称为单臂机械手组合设备和双臂机械手组合设备(dual-arm cluster tool,DACT),以下简称为单臂组合设备和双臂组合设备. 双臂组合设备有两个方向相反的机械臂,每个机械臂可以携带一片晶圆.

图1组合设备
Fig.1A cluster tool
对于一台组合设备来说,机械手活动所需的时间要比晶圆加工时间短得多,而其生产节拍(cycle time)取决于其瓶颈步骤所需加工时间,称为加工时间主导型 [5] . 由于晶圆加工时间通常远远大于机械手活动时间,大多数组合设备都是加工时间主导型的. 对于加工时间主导的单臂组合设备和双臂组合设备,分别采用拉式策略(backward strategy)和交换策略(swap strategy)[3] 能获得最优调度. 由于加工腔中残留的化学气体和热量会影响晶圆表面电路质量,已加工完的晶圆必须在有限的时间内从加工腔取出,这就是晶圆的驻留时间约束 [6] . 文献 [7] 提出的算法能够在满足晶圆驻留时间约束的条件下,减少晶圆完成加工后在加工腔中停留的时间. 文献 [8-9] 研究了双臂组合设备的最优周期调度. 文献 [10] 提出了一种改进的双臂组合设备交换策略,以减少晶圆加工后驻留时间. 通过这种方式,晶圆会在交换动作期间驻留在机械手上一段时间. 此外,文献 [11] 提出了一类新的机械手任务序列,以避免传统的交换策略无法为带有晶圆驻留时间约束的双臂组合设备实现可行的调度.
随着晶圆直径的增加和电路线宽的缩小,对晶圆制造过程的品质要求越来越高. 在生产实践中,一个加工腔处理一定数量的晶圆后,腔室内的加工环境会积累一定程度的污染物. 因此,为了确保晶圆上电路的高品质,清除腔室内残留化学物质是非常重要的. 组合设备中带有晶圆驻留时间约束和腔室清洁要求的调度问题非常具有挑战性.
Yu等人 [12-13] 研究了一种称为净化的清洁方式. 在具有腔室内清洁要求的组合设备的步骤中将部分晶圆装载到并行加工腔中; 并且一旦加工腔加工完成了一片晶圆,就会执行腔室清洁的操作. 需要注意的是,虽然这种操作可以提高加工芯片的质量,但它会降低组合设备的生产率. 此外,在连续加工一定数量的晶圆后再进行清洁腔室的情况会更加普遍. 文献 [14] 介绍了单臂组合设备的自动清洁操作. 文献 [15] 提出了一种多智能体强化学习方法,以最大化生产效率. 上述方法没有考虑晶圆驻留时间约束,而该约束条件在实际生产的过程中会直接影响晶圆表面电路质量,随着对晶圆质量的越来越严格,不可能不再考虑晶圆驻留时间约束. 因此,当考虑到晶圆的驻留时间约束时,上述方法不再适用. 文献 [16] 提出了一种处理具有清洁操作的单臂组合设备的新方法. 当加工腔需要清洁操作时,该加工腔中未完成加工的晶圆被移动到了真空锁中,这意味着工厂需要耗费额外的加工成本来处理这些真空锁中未加工完的晶圆,由于其研究对象是单臂组合设备,提出的方法不能用于解决本文研究的双臂组合设备的调度. 文献 [17] 提出了将一些虚拟晶圆装载到需要清洁的加工腔中的方法,但这种方法在针对长时间的清洁维护操作时,需要载入过多的虚拟晶圆,使得生产效率下降. 事实上,当今先进的传感器能够及时检测到化学残留物,一旦达到累积污染阈值(或加工腔连续处理的一定数量的晶圆后)则进行清洁,这称为基于条件的清洁操作. 本研究旨在解决带有晶圆驻留时间约束和基于条件的清洁操作的组合设备的调度问题.
第2节分析了组合设备机械手的活动,并给出了如何分配机械手等待时间以获得稳态下的调度; 第3节基于虚拟晶圆的方法设计了适用于带有清洁要求的组合设备的调度策略,并提出算法使组合设备能够恢复到稳态; 第4节给出了两个实例来演示所提出策略的应用; 最后一节总结了本研究.
2 稳态调度
假设在制造晶圆的双臂组合设备中有n个加工步骤,其中每个步骤可能有并行的加工腔执行相同的制造工艺. 用Nq = {0,1,2,3,· · ·,q}表示有限个连续自然数的集合,以及 = Nq\{0}表示有限个连续正整数集合. 晶圆流模式表示为(m1,m2,· · ·,mn),其中mi表示第i个步骤(其中i ∈ )的并行加工腔数量. 例如,一个晶圆流为(2,1,1)的双臂组合设备表示步骤1有两个执行相同工艺的并行加工腔,而步骤2和步骤3没有并行的加工腔,如图2所示,PC1和PC2都是执行步骤1的加工腔,而PC2和PC3分别执行步骤2和步骤3的工艺流程. 一个交换动作的任务序列应用于一个双臂组合设备 [3],则该双臂组合设备执行以下活动: <使用一个机械臂从真空锁(LL)中卸载一片晶圆并移动至加工腔1(PC1)→空闲的机械臂在PC1等待晶圆完成加工后卸载→使用该空闲的机械臂从PC1中卸载已完成加工的晶圆→旋转→等待交换操作完成→ 将另外一只机械臂中晶圆装载进入PC1→机械手从PC1移动至PC2→ · · · →将晶圆从最后一个加工腔n 移动至LL→将完成加工的晶圆装载入LL→将原料晶圆从LL卸载>.
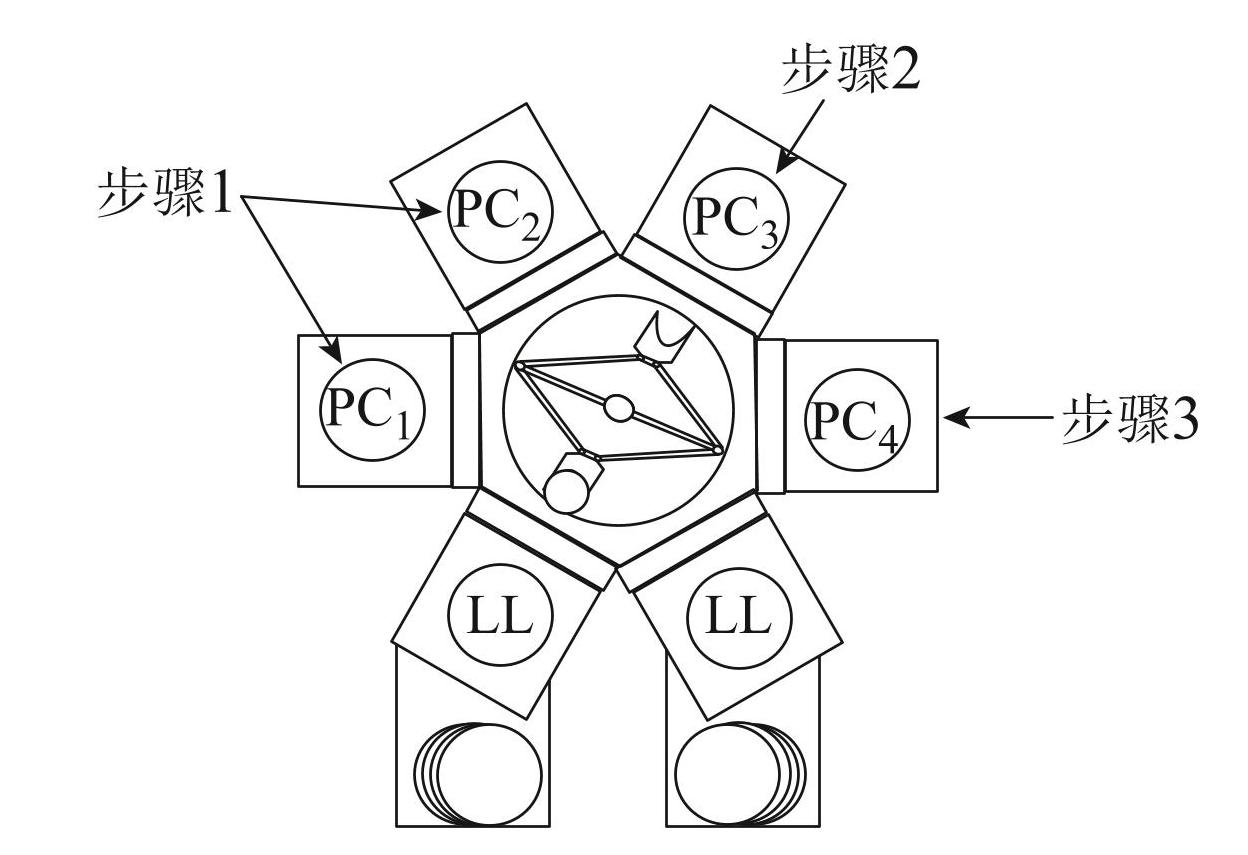
图2带有并行腔双臂组合设备示例图
Fig.2A DACT with parallel steps
假设ωi和ωiS分别表示机械手在第i步加工腔卸载晶圆前的等待时间和装载晶圆前的等待时间. 假设机械手需要λ个单位时间来装/卸载晶圆,需要µ个单位时间在两个加工腔之间移动. 在交换操作期间,包括装、卸载晶圆和旋转,需σ个单位时间. β表示机械手在交换操作期间旋转所需的时间. 因此,σ = 2λ + β. 如果λ,µ,σ是已知常量,可以通过确定ωi和ωiS来确定双臂组合设备的情况. 在一个周期内,机械手的任务时间为
(1)
假设τi表示晶圆在步骤i的晶圆驻留时间. 假设αi 和δi分别表示步骤i所需的晶圆加工时间和允许晶圆在加工后停留的时间. 为了在加工腔上完成对晶圆的加工,必须满足τi >αi . 因此,在步骤i中,完成晶圆加工的最小允许时间由ΠiL表示,计算公式为 [3]
(2)
此外,如果晶圆驻留时间约束得到满足,那么τi必须落在[αi αi + δi ]之间. 在步骤i,完成一片晶圆的允许上界时间被表示为ΠiU [3],即
(3)
设Π = max{ΠiL},i ∈ ,表示双臂组合设备的生产节拍. ψ表示机械手的生产节拍,πi表示在步骤i完成一片晶圆所需的时间. 如果πi = ψ,则可以得到一个周期调度. 如果能实现Π = ψ,则可以找到一个可行的调度,以提高生产率. 对于一个加工主导的双臂组合设备,机械手并不一直忙碌,有空闲时间在某些加工腔外等待. 假设ψ2为在不同步骤上等待时间的总和,且ψ2必须等于机械手在一个生产节拍中的空闲时间. 机械手的生产节拍由其任务时间ψ1和等待时间ψ2组成.
(4)
根据文献 [3],在步骤i,晶圆停留时间τi可以通过式(5)获得:
(5)
双臂组合设备的活动及活动所需时间如表1所示.
表1双臂组合设备的活动以及活动所需时间
Table1Symbols and associated time of operations in a DACT

对于一个加工时间主导的双臂组合设备,文献 [3] 总结了以下调度可行性条件. 组合设备是可调度的指组合设备至少存在一个可行的调度.
命题1 如果对于所有的且ψ1 Π,则带有晶圆驻留时间约束的双臂组合设备是可调度的.
定义. 设B 表示步骤 E 中加工腔的数量,令ψ2 = ψ21 + ψ22,其中: ψ21 = . 那么可以得到机械手在步骤i装载晶圆前等待时间ωiS的计算公式:

(6)
则有以下命题.
命题2 假设1)[Π1L∩Π1U]∩· · ·∩[ΠnL∩ΠnU] = ∅; 2)ΠiU ≤ Π,i ∈ E ≠∅以及Π≤ΠiU,i∈F. 那么,如果得到的ωiS满足ψ21 ≤ Π − ψ1,则带有晶圆驻留时间约束的双臂组合设备是可调度的.
机械手按顺序依次访问:LLs→PC1→PC2→ · · · →PCn→LLs→PC1→PC2→ · · · →PCn→LLs. 一般来说,在命题2的情况中,步骤i ∈ E的加工腔可处于不同的位置.
基于上述分析,可以通过计算机械手的等待时间,确定带有晶圆驻留时间约束的双臂组合设备在稳态下的调度. 这里的稳态调度,指的是组合设备的机械手按照上述顺序重复执行动作运行,并且组合设备的生产周期不变. 为此,笔者提出了算法1(如表2所示),计算机械手的等待时间,从而获得组合设备在稳态过程的一个周期调度.
表2算法1: 设置机械手的等待时间以获得稳态调度
Table2Algorithm 1: Set robot waiting time for a stead-state schedule

需要注意的是,式(5)表明,如果在步骤上,ωiS增加,则τi会减少. 因此,通过算法1和命题2,晶圆驻留时间最多可以增加εi单位时间,而不会违反步骤 i ∈ E 上的晶圆驻留时间约束. 换句话说,在命题2中,εi表示步骤i ∈ E中晶圆驻留时间的最大增量.
如果所有的ωi和ωiS(即机械手的等待时间)都被正确设置,算法1可以在稳态下找到一个调度方案.
然而,交换策略可能不适用于腔室清洁的要求. 为了解决这个问题,需要重新分配ψ2,这样的操作会使组合设备进入清洁操作的暂态、恢复到稳态的暂态. 接下来将讨论这个问题.
3 清洁态的调度分析
双臂组合设备在运行的过程中主要分为以下3个状态,分别是初始暂态(start-up period)、稳态(steadystate period)、终止暂态(close-down period). 当双臂组合设备开始工作时,先进入初始暂态; 当组合设备中每一个加工腔室都在加工晶圆且生产周期不变,则组合设备进入稳态过程运行; 当设备计划要停止运行,进入终止暂态阶段,此阶段机械手不再从真空锁卸载原料晶圆,组合设备中晶圆逐渐减少直至所有完成加工的晶圆回到真空锁,组合设备的生产周期会变化,最后停机. 对于初始和终止两个状态都属于暂态. 在清洁情况调度的问题中,当双臂组合设备需要进行清洁操作时,组合设备也将会进入到暂态阶段,生产周期会发生变化,具体可以分为: 清洁腔室的清洁暂态,以及完成清洁后恢复到稳态的恢复态. 本节提出了算法2调度组合设备从稳态转换到清洁态,算法3调度组合设备在完成清洁后转换回稳态运行. 如图3所示用状态转换图来表示双臂组合设备在各状态之间的转变以及算法步骤之间的关系.

图3DACT 状态转换图
Fig.3State transition diagram for a DACT
随着传感器技术的发展,当预测到步骤 i 的第 j 个周期需要清洁室内时,将一片虚拟晶圆装载到第 个周期的真空锁中. 虚拟晶圆按顺序访问步骤1,2,· · ·, n 的加工腔.
假设在第j个周期中,在从步骤i的加工腔卸载晶圆之后,装载了一片虚拟晶圆. 此时,组合设备进入清洁暂态,加工腔开始清洁其内部环境.
然后,机械手继续执行其他操作,直到在第(j + mi)个周期时,再次将一片真实晶圆搬运到步骤i的加工腔中,此时加工腔室内清洁操作结束. 在步骤i,机械手等待在那里卸载虚拟晶圆,并执行以下操作: 卸载虚拟晶圆→旋转→等待交换操作. 由此,可以得到虚拟晶圆在加工腔的驻留时间表达式:
(7)
让ρi表示步骤i清洁操作所需的时间. 如果ρi≤τv,则意味着通过载入一片虚拟晶圆,不需要其他调整就可以完成清洁操作且不会影响正常的交换策略,组合设备可以运行在稳态下. 然而实际上ρi比τv要长,即 ρi >τv. 在这种情况下,组合设备应该进入清洁状态运行. 在清洁暂态下,调整一些步骤的ψ2 ,增加τv,以确保加工腔有足够的时间进行清洁.
不失一般性,假设在第k个周期中的步骤c进行室内清洁, c ∈ . 让τa,b表示在第b个周期中装载到步骤a的晶圆的驻留时间. 让ωa,b和ω(a,b)S分别表示在第 b个周期中步骤a卸载晶圆之前等待的时间和装载晶圆前等待的时间.
3.1 命题1情况下的调度分析
根据式(7),载入一片虚拟晶圆后,如果步骤c中的 ω(c,k)S 增加,则τv 也会增加. 因此,如果计算出 ρc − τc,k = ∆′ 个单位时间,则令∆ = ∆′ − σ 和ω(c,k)S = ω(c,k)S + ∆,使τv等于ρc ,以满足清洁操作所需的时间. 然而,这样做也会增加其他步骤的晶圆驻留时间. 为了确保其他步骤不违反晶圆驻留时间约束,减少算法1中分配的ωn,即机械手在步骤n卸载晶圆前的等待时间. 这样,τv满足需要花费ρc单位时间进行清洁的要求,同时满足其他步骤的晶圆驻留时间约束. 如果以下条件成立,则组合设备仍是可调度的.
当c ≠ n时:
(8)
当c = n时:
(9)
例如,有4个步骤,晶圆流(m1,m2,m3,m4)=(2,2,1,1), c = 3,k = 5,即步骤3需要在第5个周期进行清洁. 在这种情况下,i = n − 1,因此式(8)中没有不等式,即在清洁暂态下没有限制条件,式(8)始终成立. 此外,如果c = 1,k = 6,即步骤1需要在第6个周期进行清洁,则条件(8)为: 和
3.2 命题2情况下的调度分析
对于命题 2的情况,类似于命题 1,令ω(c,k)S = ω(c,k)S + ∆. 使τv等于ρc以分配所需的清洁时间. 由于在算法1中,ψ2的一部分被分配给ω(n,k)S. 因此,当 c ≠ n时,即不是最后一个步骤需要进行清洁操作时,减少ωnS以降低对其他步骤的影响. 这样做是为了确保双臂组合设备在清洁暂态态下不违反晶圆驻留时间约束. 如果以下条件成立,则组合设备在清洁暂态下仍然可调度.
当c ≠ n时:
(10)
当c = n时:
(11)
基于上述两种情况的分析,本文提出算法2调度处于清洁暂态的双臂组合设备,如表3所示. 在算法2中,通过载入一片虚拟晶圆,根据不同的情况调整机械手的等待时间,延长组合设备的生产周期,保证满足晶圆驻留时间约束和清洁操作有足够的时间完成.
表3算法2: 清洁暂态的调度算法
Table3Algorithm 2: Set incremental time for a transient-state schedule

如果算法2输出ζ = 1,则可以找到清洁暂态的一个调度. 所得到的调度可以确保时间足够完成清洁操作,同时其他步骤不违反晶圆驻留时间约束. 对于命题1和2的情况,在最坏情况下,条件(8)–(11)中最多有n个不等式. 在实际生产中,加工步骤的数量大多为 1–4步,即n ∈ {1,2,3,4}. 算法2需要执行的次数由n 决定,而n在实际生产中是一个定值,因此,算法的计算复杂度是多项式.
3.3 恢复态的调度分析
当清洁暂态结束时,一片真实晶圆被机械手载入步骤i,组合设备转入恢复态并最终回到稳态.
在清洁暂态下,算法2调整机械手在步骤n的等待时间,以满足实际的清洁要求,这也使得某些步骤中的晶圆的驻留时间少于稳态下的驻留时间. 从晶圆制造的角度来看,如果τa <αa,即步骤a中的晶圆驻留时间小于步骤a所需的晶圆加工时间,则需要恢复τa 使晶圆能够完成加工. 相反,如果τa >αa,则不需要恢复τa. 因此,在清洁暂态结束时,需要确定是否有一些步骤未满足所需的加工时间. 如果有某些步骤未满足加工时间要求,则需要通过算法3满足这一条件,使得组合设备回到稳态. 基于以上讨论,提出了算法3来将组合设备恢复到稳态. 接下来讨论哪些未从加工腔中移除的晶圆会受到算法2的影响.
让R代表受算法2影响的步骤集合,m代表需要调整步骤i ∈ R的晶圆驻留时间的周期数. 让νa表示受算法2影响的步骤a晶圆驻留时间与αa的差异. 接下来分析在不同步骤进行清洁操作的情况. 由于在步骤c 中放置了一片虚拟晶圆进行清洁操作,当c ≠ n 时,即清洁步骤不是最后一步时,下一个周期中可以忽略步骤c + 1中虚拟晶圆的晶圆驻留时间约束. 上述变量可以由式(12)–(19)所得.
情况 1 如果c ≠ n,则
(12)
(13)
(14)
(15)
情况 2 如果c = n,则
(16)
(17)
(18)
(19)
例如,符合命题1的双臂组合设备具有3个步骤,其中:(m1, m2,m3)=(2,3,4), c = 2,k = 2,即第2个周期需要清洁步骤2,则需要根据τ2,5与α2做出判断. 如果τ2,5 >α2,则组合设备可以在下一个周期回到稳态. 否则,需要通过进入恢复状态来调整τ2,5. 此外,如果 c = 3,k = 1,即步骤3需要在第1个周期进行清洁,则需要检查τ1,6,τ2,6和τ3,5. 如果τ1,6 <α1或者τ2,6 <α2或者τ3,5 <α3,则组合设备必须进入恢复态状态来调整晶圆驻留时间; 反之,则在下一个周期中组合设备返回到稳态.
此外,在恢复态期间,必须确保其他步骤不违反晶圆驻留时间约束,否则,它会影响晶圆的质量. 基于以上分析,笔者提出了算法3(如表4所示): 通过调整机械手的等待时间,恢复组合设备的稳态. 根据不同的情况,计算机械手的等待时间以使组合设备回到稳态.
表4算法3: 恢复态调整算法
Table4Algorithm 3: Schedule the robot for shifting to the steady state

如果算法3输出ς = 1,则表示当清洁暂态结束时,组合设备可以在恢复态后返回到稳态,在第(k+mc+m)个周期中返回到稳态. 在恢复态下,双臂组合设备中的任何步骤都不会违反晶圆驻留时间约束,这保证了晶圆上电路的质量. 此时,整个清洁操作结束,双臂组合设备回到了稳态.
4 算例分析
在实际生产中,一台双臂组合设备最多不会有超过8个加工腔,每个步骤的并行腔室数量一般为 1–4个. 每个步骤完成一片晶圆加工所需时间一般是在30∼300 s. 加工腔处理加工若干片晶圆后,若污染物质达到设定阈值,腔室里的传感器就会发出信号给调度程序. 腔室在受到污染之后如果需要进行清洁,那么清洁操作所需的时间一般花费30∼200 s. 晶圆在加工完成后允许最长停留时间为20 s. 在本节中,选取了两个符合实际生产的算例展示所提出方法的应用和有效性. 以下默认时间单位是s.
4.1 算例1
双臂组合设备有 3个加工步骤,(m1,m2,m3)=(3,2,2). 步骤 1–3 的晶圆加工时间分别为140,90 和 95,即α1 = 140,α2 = 90以及α3 = 95. 在每个步骤中,机械手需要2 s来执行装载/卸载操作. 机械手在两个步骤之间移动所需的时间为2 s. 机械手在交换操作期间旋转所需的时间为3 s. 即λ = 2,µ = 2,β = 3以及 σ = 7. 加工完成后,晶圆必须在20 s内从加工腔中取出,即δ1 = δ2 = δ3 = 20.
算法1得到Π = 51 和ψ1 = 33. 由于 ψ1 ≤ Π,因此该双臂组合设备符合命题1的条件. 设置ω1 = ω2 =ω1S = ω2S = ω3S = 0和ω3 = 18,可以在稳态下获得可行的调度. 根据式(5)可知τ1,2 = 146及τ2,3 = 95.
假设在第2个周期的步骤1中执行清洁操作. 完成此操作需要168 s,该数值符合实际生产中清洁操作所需时间. 或者说,c = 1,k = 2,ρ1 = 168.
在第2个周期开始时,从真空锁中卸载虚拟晶圆,并在步骤1中装载到加工腔中,组合设备进入清洁暂态. 由于∆ = ρ1−τ1,2−σ = 168−146−7 = 15 >0,需要执行算法2. 由于该双臂组合设备是符合命题1的条件,设置ω(1,2)S = ω(1,2)S+∆ = 0+15 = 15. 然后,由于c ≠ n,设置ω3,2 = ω3,2 − ∆ = 18 − 15 = 3.
在这个例子中,有
因此,式(8)成立,算法2输出ζ = 1,这意味着它可以在清洁暂态下找到一个调度.
执行算法 2后,需要分析晶圆驻留时间. 通过式(12)–(15),可得R={1,2},ν1 = 9>0以及ν2 = 10>0. 因此,需要运行算法3.
算法3可以得到m = 3和γ = 5,这意味着恢复态需要持续3个周期,每个周期调整5 s. 算法3输出ς = 1,这意味着经过3个周期的调整后,算法3检查的晶圆驻留时间可以满足步骤1 以及步骤2的加工时间要求,即 α1 ≤ τ1,5 ≤ α1+ δ1以及α2 ≤ τ2,5 ≤ α2+ δ2,而其他步骤不违反晶圆驻留时间约束. 双臂组合设备在第8 个周期返回到稳态. 图4显示了从清洁暂态开始到恢复态再到稳态的调度的甘特图.

图4例1对应的调度甘特图
Fig.4Gantt chart for the schedule of Example1
4.2 算例2
双臂组合设备有两个加工步骤,(m1,m2)=(2,1). 步骤1–2的晶圆加工时间分别为100和50,即α1 = 100以及α2 = 50. 在每个步骤中,机械手需要1 s来执行装载/卸载操作. 机械手在两个步骤之间移动所需的时间为1 s. 机械手在交换操作期间旋转所需的时间为2 s. 即λ = 1,µ= 1,β = 2以及σ= 4. 加工完成后,晶圆必须在20 s内从加工腔中取出,即δ1 = δ2 = 20.
通过计算可以得到Π = 54和ψ1 = 13. 由于ψ1 ≤ Π,因此该双臂组合设备符合命题1的条件. 通过算法 1,可以得到ω1 = ω1S = ω2S = 0和ω2 = 41,获得在稳态下的调度. 根据式(5),可知τ1,3 = 104. 假设在第3个周期的步骤1中执行清洁操作. 完成此操作需要124 s,该数值符合实际生产中清洁操作所需时间. 或者说, c = 1,k = 3,ρ1 = 124.
在第3个周期开始时,从真空锁中卸载虚拟晶圆,并在步骤1中装载到加工腔中,组合设备进入清洁暂态. 由于∆ = ρ1−τ1,3−σ = 124−104−4 = 16 >0,需要执行算法2. 由于该双臂组合设备是符合命题1的条件,设置ω(1,3)S = ω(1,3)S+∆ = 0+16 = 16. 然后,由于c ≠ n,设置ω3,5 = ω3,5 − ∆ = 41 − 16 = 25.
在这个例子中,式(8)始终成立,算法2输出ζ = 1,这意味着它可以在清洁暂态下找到可行的调度.
执行算法2后,需分析晶圆驻留时间. 通过式(12)–(15),可得R={1},ν1 = 12>0. 因此,需执行算法3.
算法3可以得到m= 2和γ = 6,这意味着恢复态需要持续2个周期,每个周期调整6 s. 算法3输出ς = 1,这意味着经过2个周期的调整后,算法3检查的晶圆驻留时间可以满足步骤1的加工时间要求,即α1 ≤ τ1,4 ≤ α1 + δ1,而其他步骤不违反晶圆驻留时间约束. 双臂组合设备在第7个周期返回到稳态. 图5显示了从清洁暂态开始到恢复态再到稳态调度的甘特图.

图5例2对应的调度甘特图
Fig.5Gantt chart for the schedule of Example2
4.3 实例对比
文献 [17] 提出了一个upper bound(UB)生产指标. UB表示,在每个周期内,组合设备实际平均产出晶圆数量的上限,可以由以下公式计算:
(20)
其中vi是在第i步装载到加工腔内的虚拟晶圆数量.
若使用文献 [17] 中的方法,需要装载2片虚拟晶圆才能完成清洁任务,得到的UB分别为0.6,0.5和0.5以及0.5和0.33,低于本文算法所得的0.75,0.67和0.67以及0.67和0.5. 上述例子的结果如图6所示的直方图. 这意味着,在清洁时间较长时,与文献 [17] 相比,仅装载一片虚拟晶圆就可以实现生产率提高.
5 结束语
本文研究了半导体制造中,晶圆加工过程受到严格驻留时间约束和腔室需进行清洁操作的调度问题. 与现有的工作相比,本文侧重于更一般的情况,即在需要进行清洁操作前,一个腔室可能要加工完多片晶圆,直到腔室内残留物质达到阈值,简称基于条件的清洁操作. 为此,本文提出了一种基于装载虚拟晶圆的方法. 该方法通过仅装载一片虚拟晶圆以及调整机械手的等待时间以满足腔室内清洁要求,使得双臂组合设备在需要时执行清洁操作,从而在制造质量和生产率之间取得了良好的平衡. 这种方式既可以满足晶圆驻留时间约束又可以满足加工腔的清洁要求,这在已有研究中未见报道. 本文研究对象是双臂机械手单组合设备. 在未来工作中,将进一步研究如何将该方法推广到调度双臂多组合设备.

图6实例比较
Fig.6Comparison for Examples